低压化学气相沉积、固相晶化、准分子激光晶化、快速热退火、金属诱导晶化、等离子体增强化学反应气相沉积等是目前用于制备多晶硅薄膜的几种主要方法。这是小编为大家整理的薄膜制备技术论文,仅供参考!
薄膜制备技术论文篇一
高阻隔薄膜的制备技术
【摘 要】本文介绍了包装领域中阻隔薄膜的几种基本的制备技术,并对其技术原理和技术特点做了简要的概述,重点介绍普通包装薄膜表面沉积纳米SiOx作为阻隔材料的优越性和制备方法。纳米氧化硅薄膜制备包括:物理气相沉积,化学气相沉积两种。物理气相沉积技术较成熟,已广泛用于当今的众多薄膜生产厂家;化学气相沉积技术由于沉积速率慢,生产成本高,耗资大,限制了工业化应用。本文还介绍了一种能够克服上述限制因素的新技术,从而使薄膜的阻隔性能大大提高。
【关键词】纳米氧化硅薄膜 阻隔性能 物理气相沉积 化学气相沉积
引言
社会发展表现在不仅对普通包装材料数量上的增加,对优质保质保鲜包装材料品种和质量的需求也在日益增加。如在食品和医药包装领域中,包装材料的阻水阻气要求越来越高。高阻隔包装材料通常指对气液渗透物具有高阻尼作用的材料,即防止氧的侵入以免商品氧化变质,防止水或水蒸气的渗透以免商品受潮霉变,防止香气、香味和二氧化碳外逸,以免商品变味和变质等。目前阻隔性包装材料已经成为包装材料的发展趋势,并广泛用于各种应用领域,如电子显示领域的OLED[1]。
1 阻隔材料的发展历程及趋势
阻隔包装材料的发展历程可分为三个阶段:第一代包装材料如PE、PP、PET、PVDC、PVC等。因其阻隔性达不到要求(见表1),使用越来越少。采用高聚物(比如PEN)可以解决阻隔性和用金属探测器检查问题,但是成本太高,并且难于循环利用。采用复合膜结构,如三层复合膜PA/黏合剂/PE、五层复合膜LDPE/粘合剂/EVOH/黏合剂/LDPE等,阻隔性能大大提高,但工艺复杂、回收困难、污染环境和成本高,应用也受到限制。第二代现代包装材料采用蒸镀铝箔/薄膜镀铝作为阻隔层,工艺简单,对空气、水分阻隔性高。但镀铝薄膜存在的问题是不透明,不适宜用于微波加工,不能用金属探测器检查,消耗资源和能源量大,无法回收,造成环境污染等。20世纪80年代末,在西方发达国家出现了对薄膜表面沉积纳米SiOx阻隔层的第三代现代包装材料研究[4]。新一代阻隔膜的技术表现出阻隔性高、 节省资源、成本低等优点。如沉积二氧化硅的PET用于啤酒、果汁等软饮料的包装中,对氧气、二氧化碳、水气和风味等的阻隔性良好,满足了其所需的包装要求。但是采用二氧化硅涂层的PET表面薄膜略带颜色,特别是柔韧性不好,与其它薄膜复合时容易出现裂纹,这影响其应用范围。
高阻隔薄膜发展除了满足包装材料的基本的要求外,其绿色环保、节省能源、可回收利用等也是现代包装材料的基本要求。其发展趋势包括如下两点[5]。
(1)新型高阻隔性能的塑料研制开发,如PVDC、EVOH等。日本可乐丽公司开发出一种新型复合膜为基材,以OPP复合一种特殊的乙烯-乙烯醇共聚物。具有EVAL和OPP两者的性能,包括透气性好、透明度高、加工容易、焚化时不产生有害气体。美国SuperexPolymer公司成功地开发了一种多层复合的食品包装材料-液晶聚合物(LCP)。其阻隔性能比EVOH高出8倍,而生产成本却比EVOH低至少20%。
(2)是对现有的塑料包装材料进行改性。用喷涂金属氧化物的方法为塑料薄膜提供了高阻隔的特性。如将高纯度SiO2喷涂到塑料薄膜表面,沉积厚度为80nm-100nm。这种材料就具有接近玻璃的阻隔性,而且透明、耐蒸煮、隔氧性能比聚酯膜高120倍,隔水性高45倍。
采用纳米SiOx作为阻隔层是高阻隔包装的发展趋势。日本、美国、欧洲等发达国家已经开发了系列SiOx复合薄膜产品包装,取代了铝塑复合包装材料,获得了满意的包装有效期和消费者的好评 [2]。专家预测,未来10年,氧化硅(SiOx)涂塑包装材料将成为新一代阻隔包装材料[3]。目前高阻隔材料制备主要是对聚酯薄膜表面进行氧化硅改性,即采用不同技术在其表面涂覆一层无机氧化硅材料,所用的涂覆技术主要有:物理方法,如电子束蒸镀、磁控溅射沉积、热蒸发和Sol-gol法,和等离子体增强化学气相沉积技术。在等离子体化学气相沉积时,采用不同的等离子体源,对薄膜的性能影响很大,特别是对薄膜的透明性有很大影响。
2 氧化硅薄膜的制备技术概述
2.1 物理气相沉积
物理气相沉积法可分为蒸镀法、溅射法和涂敷法。其中电阻式蒸发源以电阻丝加热,温度可达1700℃,蒸发氧化硅;电子枪蒸发,是通过电子束高能量,达20kW/cm2,温度更可达3000℃-6000℃把氧化硅加热;氧化硅物理气相沉积原材料通常以SiO或SiO2,或SiO和SiO2以一定的比例混合作为。
而溅射法制备氧化硅,是采用磁控溅射技术把氧化硅靶溅射起来,再进行沉积。磁控溅射就是通过离子轰击靶材后,产生的溅射粒子沉积在基材表面的工艺过程。与蒸发法相比,此镀膜层与基材的结合力强,镀膜层致密、均匀、沉积温度低、靶材不受限制、镀膜质量好等优点。还有其它优点,如设备简单、操作方便、控制容易。在溅射镀膜过程中,只要保持工作气压和溅射功率恒定,基本上可获得稳定的沉积速率,沉积速率相对较低是此技术的最大缺点。磁控溅射的一个重要发展方向是反应磁控溅射,产生于20世纪80年代前。反应磁控溅射存在的问题主要是靶中毒引起的打火和溅射过程不稳定,膜的缺陷密度较高,这些都限制了它的应用发展。总体来讲,目前物理气相沉积技术已经发展为较成熟的镀膜工艺,广泛用于各类材料的制备工艺中。
2.2 等离子体增强化学气相沉积
等离子体化学气相沉积机理为:构成有机化合物的许多键能为几个电子伏特(某些分子的键能见表2)。其结合能的大小与等离子体中的电子、光子、离子的能量相接近。
因此,当等离子体中的电子、离子或载能基团达到介质表面时,可以轻易地把这些链打开,产生自由基和反应基团,有利于材料表面改性。用这种方法制备的聚合膜表现出具有特殊的化学物理性能。等离子体增强化学气相沉积氧化硅正是基于这个原理。采用有机硅化合物作为单体,用等离子体手段先进行离解,然后在基材表面聚合沉积,是一种新的SiOx薄膜制备手段,大大拓展了等离子体应用的领域。根据放电方式的不同主要分为中频聚合、RF聚合、微波聚合等。 潘宁放电等离子体增强化学气相沉积技术(PDPs),是较好地可以制备氧化硅薄膜的方法之一。与其他沉积方法相比,其优点有以下几点。
(1)表面沉积的均匀性。利用霍尔效应控制原理,交叉垂直的磁场和电场结构将高密度均匀等离子体约束在上、下两电极之间,保证了在宽基材上均匀沉积氧化硅薄膜的。
(2)低温、低压沉积过程。在低压下(100mTorr)不但产生低的离子温度和中性粒子温度,而且也产生高的电子温度,有利于各种粒子和激发粒子的沉积。在低温低压下沉积结果是在较低的基材温度下产生高速率高质量的等离子体增强化学气相沉积薄膜。
(3)高沉积速率。在霍尔电流的两电极之间空隙的中心是一个被称为虚阴极的空间。当电子在霍尔电流中形成时,加速飞进中心空隙区域。霍尔约束电流和中心离子流结合在两电极之间产生致密等离子体,这种致密的带电离子密度可达1012/cm3。
结语
纳米SiOx高阻隔包装薄膜具有明显的优异性能,逐渐成为新一代的包装阻隔材料。SiOx薄膜的制备方法主要包括物理蒸镀和化学气相沉积,目前磁控溅射技术已在工业上广泛应用。同时潘宁放电等离子体增强化学沉积技术由于沉积速率高、设备简单、沉积氧化硅层阻隔性高与基材结合力好等优势将成为氧化硅阻隔薄膜的发展趋势。随着涂覆技术的发展,SiOx薄膜在阻隔包装领域将有更为广泛的应用,而PDPs将为氧化硅涂覆薄膜的工业化生产奠定基础。
参考文献
[1]R.Rank,T.Wunsche,S.Gunther,Surface and Coatings Technology, 2003 174-175:218-221.
[2]L. Zajickova, V. Bursikova, V. Perina, A. Machova, D. Subedi, J. Janca, S.Smirnov, Surface and Coating Technology, 2001 142-144:449-454.
[3]G. Czeremuszkin, M. Latreche, M. R. Wertheimer, and A. S. da Silva Sobrinbo, Plasmas and Polyers, 2001 Vol. 6, No. I/2, June:107-120.
[4] John Madocks, Jennifer Rewhinkle, Loren Barton, SVC Annual Technical Conference 2004:1-12.
[5] C. Lasorsaa, P.J. Morando, A. Rodrigo, Surface & Coatings Technology, 2005, 194: 42-47.
薄膜制备技术论文篇二
多晶硅薄膜的制备方法
摘要:低压化学气相沉积、固相晶化、准分子激光晶化、快速热退火、金属诱导晶化、等离子体增强化学反应气相沉积等是目前用于制备多晶硅薄膜的几种主要方法。它们具有各自不同的制备原理、晶化机理、及其优缺点。
关键词:氢化非晶硅 多晶硅 晶化
The preparation methods of polycrystalline silicon film
Abstract: At present,The preparation methods of polycrystalline silicon film,including Low pressure Chemical Vapor Deposition、Solide Phase Crystallization、Excimer Laser Annealing、 Rapid Thermal Annealing、Metal Induced Crystallization、plasma enhanced chemical vapor deposition,are bEing developed. we review typical preparation methods of polycrystalline silicon film、Crystallization Mechanism、thEIr Advantage and Disadvantage.
Keywords: a-Si:H,Polycrystalline silicon, Crystallization
1 前言
多晶硅薄膜材料同时具有单晶硅材料的高迁移率及非晶硅材料的可大面积、低成本制备的优点。因此,对于多晶硅薄膜材料的研究越来越引起人们的关注,多晶硅薄膜的制备工艺可分为两大类:一类是高温工艺,制备过程中温度高于600℃,衬底使用昂贵的石英,但制备工艺较简单。另一类是低温工艺,整个加工工艺温度低于600℃,可用廉价玻璃作衬底,因此可以大面积制作,但是制备工艺较复杂。目前制备多晶硅薄膜的方法主要有如下几种:
2 低压化学气相沉积(LPCVD)
这是一种直接生成多晶硅的方法。LPCVD是集成电路中所用多晶硅薄膜的制备中普遍采用的标准方法,具有生长速度快,成膜致密、均匀,装片容量大等特点。多晶硅薄膜可采用硅烷气体通过LPCVD法直接沉积在衬底上,典型的沉积参数是:硅烷压力为13.3~26.6Pa,沉积温度Td=580~630℃,生长速率5~10nm/min。由于沉积温度较高,如普通玻璃的软化温度处于500~600℃,则不能采用廉价的普通玻璃而必须使用昂贵的石英作衬底。 LPCVD法生长的多晶硅薄膜,晶粒具有<110>择优取向,形貌呈“V”字形,内含高密度的微挛晶缺陷,且晶粒尺寸小,载流子迁移率不够大而使其在器件应用方面受到一定限制。虽然减少硅烷压力有助于增大晶粒尺寸,但往往伴随着表面粗糙度的增加,对载流子的迁移率与器件的电学稳定性产生不利影响。
3 固相晶化(SPC)
所谓固相晶化,是指非晶固体发生晶化的温度低于其熔融后结晶的温度。这是一种间接生成多晶硅的方法,先以硅烷气体作为原材料,用LPCVD方法在550℃左右沉积a-Si:H薄膜,然后将薄膜在600℃以上的高温下使其熔化,再在温度稍低的时候出现晶核,随着温度的降低熔融的硅在晶核上继续晶化而使晶粒增大转化为多晶硅薄膜。使用这种方法,多晶硅薄膜的晶粒大小依赖于薄膜的厚度和结晶温度。退火温度是影响晶化效果的重要因素,在700℃以下的退火温度范围内,温度越低,成核速率越低,退火时间相等时所能得到的晶粒尺寸越大;而在700℃以上,由于此时晶界移动引起了晶粒的相互吞并,使得在此温度范围内,晶粒尺寸随温度的升高而增大。经大量研究表明,利用该方法制得的多晶硅晶粒尺寸还与初始薄膜样品的无序程度密切相关,T.Aoyama等人对初始材料的沉积条件对固相晶化的影响进行了研究,发现初始材料越无序,固相晶化过程中成核速率越低,晶粒尺寸越大。由于在结晶过程中晶核的形成是自发的,因此,SPC多晶硅薄膜晶粒的晶面取向是随机的。相邻晶粒晶面取向不同将形成较高的势垒,需要进行氢化处理来提高SPC多晶硅的性能。这种技术的优点是能制备大面积的薄膜, 晶粒尺寸大于直接沉积的多晶硅。可进行原位掺杂,成本低,工艺简单,易于形成生产线。由于SPC是在非晶硅熔融温度下结晶,属于高温晶化过程,温度高于600℃,通常需要1100 ℃左右,退火时间长达10个小时以上,不适用于玻璃基底,基底材料采用石英或单晶硅,用于制作小尺寸器件,如液晶光阀、摄像机取景器等。
4 准分子激光晶化(ELA)
激光晶化相对于固相晶化制备多晶硅来说更为理想,其利用瞬间激光脉冲产生的高能量入射到非晶硅薄膜表面,仅在薄膜表层100nm厚的深度产生热能效应,使a-Si薄膜在瞬间达到1000℃左右,从而实现a-Si向p-Si的转变。在此过程中,激光脉冲的瞬间(15~50ns )能量被a-Si薄膜吸收并转化为相变能,因此,不会有过多的热能传导到薄膜衬底,合理选择激光的波长和功率,使用激光加热就能够使a-Si薄膜达到熔化的温度且保证基片的温度低于450℃,可以采用玻璃基板作为衬底,既实现了p-Si薄膜的制备,又能满足LCD及OEL对透明衬底的要求。其主要优点为脉冲宽度短(15~50ns ),衬底发热小。通过选择还可获得混合晶化,即多晶硅和非晶硅的混合体。准分子激光退火晶化的机理:激光辐射到a-Si的表面,使其表面在温度到达熔点时即达到了晶化域值能量密度Ec。a-Si在激光辐射下吸收能量,激发了不平衡的电子-空穴对,增加了自由电子的导电能量,热电子-空穴对在热化时间内用无辐射复合的途径将自己的能量传给晶格,导致近表层极其迅速的升温,由于非晶硅材料具有大量的隙态和深能级,无辐射跃迁是主要的复合过程,因而具有较高的光热转换效率,若激光的能量密度达到域值能量密度Ec时,即半导体加热至熔点温度,薄膜的表面会熔化,熔化的前沿会以约10m/s的速度深入材料内部,经过激光照射,薄膜形成一定深度的融层,停止照射后,融层开始以108-1010K/s的速度冷却,而固相和液相之间的界面将以1-2m/s的速度回到表面,冷却之后薄膜晶化为多晶,随着激光能量密度的增大,晶粒的尺寸增大,当非晶薄膜完全熔化时,薄膜晶化为微晶或多晶,若激光能量密度小于域值能量密度Ec,即所吸收的能量不足以使表面温度升至熔点,则薄膜不发生晶化。一般情况下,能量密度增大,晶粒增大,薄膜的迁移率相应增大,当Si膜接近全部熔化时,晶粒最大。但能量受激光器的限制,不能无限增大,太大的能量密度反而令迁移率下降。激光波长对晶化效果影响也很大,波长越长,激光能量注入Si膜越深,晶化效果越好。 ELA法制备的多晶硅薄膜晶粒大、空间选择性好,掺杂效率高、晶内缺陷少、电学特性好、迁移率高达到400cm2/v.s,是目前综合性能最好的低温多晶硅薄膜。工艺成熟度高,已有大型的生产线设备,但它也有自身的缺点,晶粒尺寸对激光功率敏感,大面积均匀性较差。重复性差、设备成本高,维护复杂。
5 快速热退火(RTA)
一般而言,快速退火处理过程包含三个阶段:升温阶段、稳定阶段和冷却阶段。当退火炉的电源一打开,温度就随着时间而上升,这一阶段称为升温阶段。单位时间内温度的变化量是很容易控制的。在升温过程结束后,温度就处于一个稳定阶段。最后,当退火炉的电源关掉后,温度就随着时间而降低,这一阶段称为冷却阶段。用含氢非晶硅作为初始材料,进行退火处理。平衡温度控制在600℃以上,纳米硅晶粒能在非晶硅薄膜中形成,而且所形成的纳米硅晶粒的大小随着退火过程中的升温快慢而变化。在升温过程中,若单位时间内温度变化量较大时(如100℃/s),则所形成纳米硅晶粒较小(1.6~15nm);若单位时间内温度变化量较小(如1℃/s),则纳米硅粒较大(23~46nm)。进一步的实验表明:延长退火时间和提高退火温度并不能改变所形成的纳米硅晶粒的大小;而在退火时,温度上升快慢直接影响着所形成的纳米硅晶粒大小。为了弄清楚升温量变化快慢对所形成的纳米硅大小晶粒的影响,采用晶体生长中成核理论。在晶体生长中需要两步:第一步是成核,第二步是生长。也就是说。在第一步中需要足够量的生长仔晶。结果显示:升温快慢影响所形成的仔晶密度.若单位时间内温度变化量大,则产生的仔晶密度大;反之,若单位时间内温度变化量小,则产生的仔晶密度小。RTA退火时升高退火温度或延长退火时间并不能消除薄膜中的非晶部分,薛清等人提出一种从非晶硅中分形生长出纳米硅的生长机理:分形生长。从下到上,只要温度不太高以致相邻的纳米硅岛不熔化,那么即使提高退火温度或延长退火时间都不能完全消除其中的非晶部分。 RTA退火法制备的多晶硅晶粒尺寸小,晶体内部晶界密度大,材料缺陷密度高,而且属于高温退火方法,不适合于以玻璃为衬底制备多晶硅。
6 等离子体增强化学反应气相沉积(PECVD)
等离子体增强化学反应气相沉积(PECVD)法是利用辉光放电的电子来激活化学气相沉积反应的。起初,气体由于受到紫外线等高能宇宙射线的辐射,总不可避免的有轻微的电离,存在着少量的电子。在充有稀薄气体的反应容器中引进激发源(例如,直流高压、射频、脉冲电源等),电子在电场的加速作用下获得能量,当它和气体中的中性粒子发生非弹性碰撞时,就有可能使之产生二次电子,如此反复的进行碰撞及电离,结果将产生大量的离子和电子。由于其中正负粒子数目相等。故称为等离子体,并以发光的形式释放出多余的能量,即形成“辉光”。在等离子体中,由于电子和离子的质量相差悬殊,二者通过碰撞交换能量的过程比较缓慢,所以在等离子体内部各种带电粒子各自达到其热力学平衡状态,于是在这样的等离子体中将没有统一的温度,就只有所谓的电子温度和离子温度。此时电子的温度可达104℃,而分子、原子、离子的温度却只有25~300℃。所以,从宏观上来看,这种等离子的温度不高,但其内部电子却处于高能状态,具有较高的化学活性。若受激发的能量超过化学反应所需要的热能激活,这时受激发的电子能量(1~10eV)足以打开分子键,导致具有化学活性的物质产生。因此,原来需要高温下才能进行的化学反应,通过放电等离子体的作用,在较低温度下甚至在常温下也能够发生。
PECVD法沉积薄膜的过程可以概括为三个阶段:
1.SiH4分解产生活性粒子Si、H、SiH2 和SiH3等;
2.活性粒子在衬底表面的吸附和扩散;
3.在衬底上被吸附的活性分子在表面上发生反应生成Poly-Si层,并放出H2;
研究表面,在等离子体辅助沉积过程中,离子、荷电集团对沉积表面的轰击作用是影响结晶质量的重要因素之一。克服这种影响是通过外加偏压抑制或增强。对于采用PECVD技术制备多晶体硅薄膜的晶化过程,目前有两种主要的观点.一种认为是活性粒子先吸附到衬底表面,再发生各种迁移、反应、解离等表面过程,从而形成晶相结构,因此,衬底的表面状态对薄膜的晶化起到非常重要的作用.另一种认为是空间气相反应对薄膜的低温晶化起到更为重要的作用,即具有晶相结构的颗粒首先在空间等离子体区形成,而后再扩散到衬底表面长大成多晶膜。对于SiH4:H2气体系统,有研究表明,在高氢掺杂的条件下,当用RF PECVD的方法沉积多晶硅薄膜时,必须采用衬底加热到600℃以上的办法,才能促进最初成长阶段晶核的形成。而当衬底温度小于300℃时,只能形成氢化非晶硅(a-Si:H)薄膜。以SiH4:H2为气源沉积多晶硅温度较高,一般高于600℃,属于高温工艺,不适用于玻璃基底。目前有报道用SiC14:H2或者SiF4:H2为气源沉积多晶硅,温度较低,在300℃左右即可获得多晶硅,但用CVD法制备得多晶硅晶粒尺寸小,一般不超过50nm,晶内缺陷多,晶界多。
7 金属横向诱导法(MILC)
20世纪90年代初发现a-Si中加入一些金属如Al,Cu,Au,Ag,Ni等沉积在a-Si∶H上或离子注入到a-Si∶H薄膜的内部,能够降低a-Si向p-Si转变的相变能量,之后对Ni/a-Si:H进行退火处理以使a-Si薄膜晶化,晶化温度可低于500℃。但由于存在金属污染未能在TFT中 应用。随后发现Ni横向诱导晶化可以避免孪晶产生,镍硅化合物的晶格常数与单晶硅相近、低互溶性和适当的相变能量,使用镍金属诱导a-Si薄膜的方法得到了横向结晶的多晶硅薄膜。横向结晶的多晶硅薄膜的表面平滑,具有长晶粒和连续晶界的特征,晶界势垒高度低于SPC多晶硅的晶界势垒高度,因此,MILC TFT具有优良的性能而且不必要进行氢化处理。利用金属如镍等在非晶硅薄膜表面形成诱导层,金属Ni与a-Si在界面处形成NiSi2的硅化物,利用硅化物释放的潜热及界面处因晶格失错而提供的晶格位置,a-Si原子在界面处重结晶,形成多晶硅晶粒,NiSi2层破坏,Ni原子逐渐向a-Si层的底层迁移,再形成NiSi2硅化物,如此反复直a-Si层基本上全部晶化,其诱导温度一般在500℃,持续时间在1O小时左右,退火时间与薄膜厚度有关。
金属诱导非晶硅晶化法制备多晶硅薄膜具有均匀性高、成本低、相连金属掩蔽区以外的非晶硅也可以被晶化、生长温度在500℃。但是MILC目前它的晶化速率仍然不高,并且随着热处理时间的增长速率会降低。我们采用MILC和光脉冲辐射相结合的方法,实现了a-Si薄膜在低温 环境下快速横向晶化。得到高迁移率、低金属污染的多晶硅带。
8 结束语
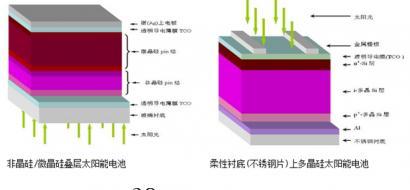
除了上述几种制备多晶硅薄膜的主要方法外,还有超高真空化学气相沉积(UHV/CVD )、 电子束蒸发等。用UHV/CVD生长多晶硅,当生长温度低于550℃时能生成高质量细颗粒多晶硅薄膜,不用再结晶处理,这是传统CVD做不到的,因此该法很适用于低温多晶硅薄膜晶体管制备。另外,日立公司研究指出,多晶硅还可用电子束蒸发来实现,温度低于530℃。因此,我们相信随着上述几种多晶硅制备方法的日益成熟和新的制备方法的出现,多晶硅技术的 发展必将跨上一个新的台阶,从而推动整个半导体产业和相关行业的发展。
参考文献:
[1] 懂会宁等,非晶硅的二步快速退火固相晶化,四川大学学报[J], 1995, 0l:95~97
[2] 曾祥斌。多晶硅薄膜的新型激光晶化制备方法[J]电子元件与材料,2000,01:7~8
[3] 刘传珍等。激光退火法低温制备多晶硅搏膜的研究[J]。液晶与显示,2000,01:46~51
[4] 刘传珍等。金属诱导法低温多晶硅薄膜的制备与研究[J]。半导体学报,2001,01:61~65
[5] 邱法斌等。准分子激光烧结玻璃衬底上多晶硅薄膜材料的制备[J]。液晶与显示,2001,03:170~174
[6] 卓铭。金属Ni诱导横向晶化的结构及工艺进程的优化[J]。半导体学报,2002,11:1217~1223
[7] 刘丰珍。等离子体-热丝CVD技术制备多晶硅薄膜[J]。半导体学报,2003,05:499~503
[8] 邱春文等。PECVD法低温沉积多晶硅薄膜的研究[J]。液晶与显示,2003,03:201~204
[9] Giust G.K, Sigmon T.W. Laser-processed thin-film transistors fabricated from sputtered amorphous silicon films. IEEE Trans Electron Devices, 2000, 47(1):207
[10] WangWen,MengZhi guo, Low Temperature Metal Induced Laterally Crystallized Polycrystallline S-ilicon Material and DeviceTechnology,2003,5:87
[11] Zhu M,Guo X,et al.Thin Solid Films, 2000, 205~306
 爱华网
爱华网


